碳化硅器件制造那些事儿
碳化硅器件制造那些事儿
我们知道,在半导体领域里,单晶硅(Si)是全球应用最广泛、产量最大的半导体基础材料,目前90%以上的半导体产品都是使用硅基材料制造。随着现代能源领域对高功率、高电压器件的需求徒增,对半导体材料的禁带宽度、击穿电场强度、电子饱和速率、热导率等关键参数也提出了更加严苛的要求。在此情况下,以碳化硅(SiC)为代表的宽禁带半导体材料脱颖而出,成为高功率密度应用的宠儿。
碳化硅作为一种化合物半导体,在自然界中极其稀有,以矿物莫桑石的形式出现。目前世界上销售的碳化硅几乎都是人工合成的。碳化硅具有硬度高、热导率高、热稳定性好、临界击穿电场高等优点,是制作高压大功率半导体器件的理想材料。那么,碳化硅功率半导体器件是怎样制造出来的呢?碳化硅器件制造工艺与传统硅基制造工艺又有什么区别呢?本期开始,“碳化硅器件制造那些事儿”,将为大家一一揭秘。
一
碳化硅器件制造的工艺流程
碳化硅器件制造环节与硅基器件的制造工艺流程大体类似,主要包括光刻、清洗、掺杂、蚀刻、成膜、减薄等工艺。不少功率器件制造厂商在硅基制造流程基础上进行产线升级便可满足碳化硅器件的制造需求。而碳化硅材料的特殊性质决定其器件制造中某些工艺需要依靠特定设备进行特殊开发,以促使碳化硅器件耐高压、大电流功能的实现。
二
碳化硅特色工艺模块简介
碳化硅特色工艺模块主要涵盖注入掺杂、栅结构成型、形貌刻蚀、金属化、减薄工艺。
(1)注入掺杂:由于碳化硅中碳硅键能高,杂质原子在碳化硅中难以扩散,制备碳化硅器件时PN结的掺杂只能依靠高温下离子注入的方式实现。注入掺杂通常为硼、磷等杂质离子,掺杂注入深度通常为0.1μm~3μm。高能量的离子注入会破坏碳化硅材料本身的晶格结构,需要采用高温退火修复离子注入带来的晶格损伤,同时控制退火对表面粗糙度的影响。核心工艺为高温离子注入和高温退火。
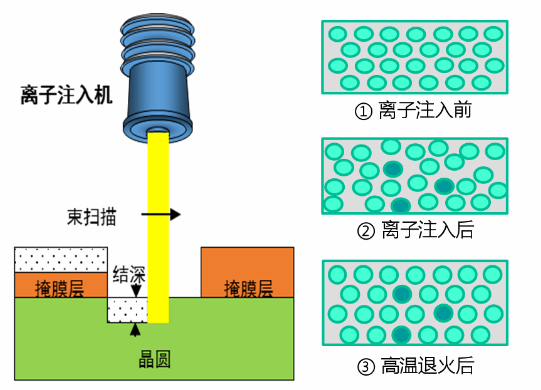
图1 离子注入和高温退火效果示意图
(2)栅结构成型:SiC/SiO2界面质量对MOSFET沟道迁移和栅极可靠性影响很大,需要开发特定的栅氧及氧化后退火工艺,以特殊原子(例如氮原子)补偿SiC/SiO2界面处的悬挂键,满足高质量SiC/SiO2界面以及器件高迁移的性能需求。核心工艺为栅氧高温氧化、LPCVD、PECVD。

图2 普通氧化膜淀积和高温氧化示意图
(3)形貌刻蚀:碳化硅材料在化学溶剂中呈现惰性,精确的形貌控制只有通过干法刻蚀方法实现;掩膜材料、掩膜蚀刻的选择、混合气体、侧壁的控制、蚀刻速率、侧壁粗糙度等都需要根据碳化硅材料特性开发。核心工艺为薄膜沉积、光刻、介质膜腐蚀、干法刻蚀工艺。
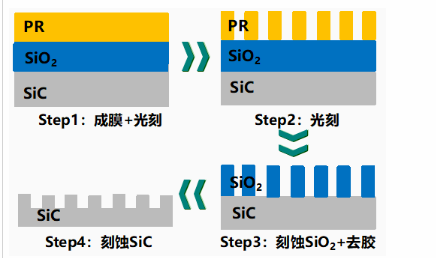
图3 碳化硅刻蚀过程示意图
(4)金属化:器件的源电极需要金属与碳化硅形成良好的低电阻欧姆接触。这不仅需要调控金属淀积工艺,控制金属-半导体接触的界面状态,还需采用高温退火的方式降低肖特基势垒高度,实现金属-碳化硅欧姆接触。核心工艺是金属磁控溅射、电子束蒸发、快速热退火。
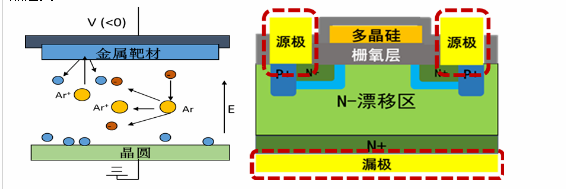
图4 磁控溅射原理和金属化效果示意图
(5)减薄工艺:碳化硅材料具有高硬度、高脆性和低断裂韧性的特点,其研磨加工过程中易引起材料的脆性断裂,对晶圆表面与亚表面造成损伤,需要新开发研磨工艺来满足碳化硅器件制造需求。核心工艺是磨片减薄、贴膜揭膜等。
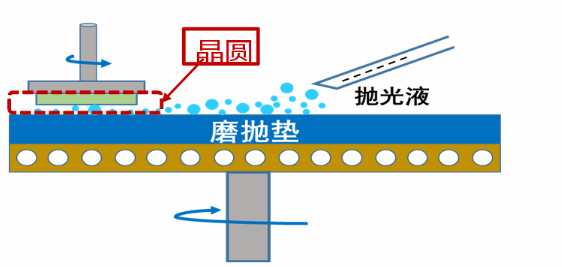
图5 晶圆磨抛/减薄原理示意图
转载微信公众号:宽禁带半导体技术创新联盟
声明:本文版权归原作者所有,转发仅为更大范围传播,若有异议请联系我们修改或删除:zhangkai@cgbtek.com

